Vezetők, félvezetők és szigetelők, szilícium
Ezzel szemben, a germánium, szilícium egyike a leggyakoribb elem a földkéreg, ha tartalmazza 29,5% (tömeg). Mivel a prevalenciája szilícium a második csak oxigén elemek közötti. Számos szilícium-vegyület tartalmaz egy többsége kőzetek és ásványok. Homok és agyag ásványi részét képező talaj, is képviselnek szilícium vegyület. A leggyakoribb vegyület ez az elem a szilícium-dioxid SiO2. Szabad szilícium-dioxid fordul elő, főleg a formában az ásványi kvarc. Egyes területeken tisztaságú kvarchomok eléri 99,9%. A szilícium szabad állapotban a természetben nem fordul elő. Az elemi formában először elő 1811-ben, azaz sokkal korábban, mint Németországban. Ugyanakkor, mivel a félvezető áramkör anyag szilícium már széles körben használják csak a második felében a század után a hatékony módszerek a tisztítás.
Előállítása szilícium. A kiindulási anyagot a készítmény a természetes szilícium-dioxid (szilika), amelyből szilícium visszanyert széntartalmú anyag elektromos kemencékben. Műszaki szilícium finomszemcsés fritt, amely körülbelül 1% szennyeződést.
A technológia előállítására félvezető tisztaságú szilícium a következő műveleteket tartalmazza: 1) konverziója szilícium illékony vegyületet, amely tisztítás után könnyen vissza; 2) tisztítása vegyület fizikai és kémiai módszerekkel; 3) csökkentve a vegyület felszabadulását a tiszta szilícium; 4) A végső kristályos ításos tisztítási és a növekedés az egykristályok.
A félvezető gyártás a legelterjedtebb módszer a hidrogénes redukciója triklórszilán SiHCl3. Az utóbbit kezelésével előállított a zúzott műszaki szilícium száraz hidrogén-klorid hőmérsékleten 300-400 ° C-on:
Triklór-egy folyadék forráspontja 32 ° C-on Ezért könnyen tisztítható extrakcióval, adszorpciós és desztillációs.
Fizikai, kémiai és elektromos tulajdonságait. Silicon kristályosodik a gyémánt szerkezetű valamivel kevesebb, mint a germánium kristályrács időszak identitását. Kisebb, mint a germánium, távolságok atomok között a rács okoz erősebb kovalens kötés, és ennek következtében, a szélesebb bandgap.
Kémiailag kristályos szilícium szobahőmérsékleten egy viszonylag inert anyagnak. Nem oldódik vízben, nem reagál számos savval bármilyen koncentrációban. Könnyen oldható csak keverékében salétromsav és hidrogén-fluorid savakkal és lúgokkal forráspontja.
Szilícium levegőn stabil hevítésével a 900sS. E hőmérséklet felett, elkezd gyorsan oxidálódik SiO2-dioxid. Hevítve szilícium könnyen reakcióba lép a halogének, és hőmérsékleten 1100 - 1300 ° C képes közvetlenül kommunikálni a nitrogénatommal együtt egy nitrid Si3N4. Szilícium igen jól oldódik sok olvadt fémek (Al, Ga, Sn, Au, Ag, stb). A számos fémek (. Cr, Mo, Fe, Cu, Mg, stb) képez stabil kémiai vegyület - szilicidek. Szilícium van egy viszonylag magas olvadáspontú és az olvadt állapotban nagy a reaktivitása, így vannak nagy nehézségek Az anyag kiválasztásakor a tégelyben növekvő egykristályok. A legtisztább anyagok (kvarc, grafit), melynek jellemzően gyártott olvasztótégelyek és csónakok magas hőmérsékleten reagálnak a szilícium. Ennek eredményeként a reakció szilícium szén képződött Karbid Kremniya SiC - egy nagyon stabil kémiai vegyület félvezető tulajdonságokkal.
A viselkedés a szennyeződések szilícium engedelmeskedik lényegében azonos törvények, mint a germánium. Atomjai elemek III és V a periódusos rendszer, mint akceptorok és donorok, illetve hozzon létre sekély szintje a tiltott sávban. Azonban, mivel a legalacsonyabb a dielektromos állandója, és nagyobb effektív tömegének töltéshordozók ionizációs energia sekély donorok és akceptorok szilícium lényegesen nagyobb, mint a germánium és a legtöbb szennyeződés mintegy 0,05 eV. Azonban, ebben az esetben, a szobahőmérséklet megegyezik a kimerülése szennyeződések.
Ellentétben germánium, szilikon, nagy mennyiségek tisztítására a szennyeződések végezzük kémiai módszerekkel, amelyek lesz szó yunite 2.
Silicon epitaxia. A planáris technológiát szilícium eszközök és az integrált áramkörök fontos szerepet játszanak során epitaxiális lerakódását vékony rétegben. A kifejezés epitaxia jelenti orientált egykristály építmény felületén a többi kristály szolgáló szubsztrát. A leggyakoribb formája az ipari technológiával termelő epitaxiális réteg szilícium folyamat alapul hidrogénes redukciója szilícium-tetrakloridot a következő reakcióegyenlet szerint:
A reakció zajlik kvarc reaktorok vagy hőmérséklet körülbelül 1200 ° C-on A szubsztrátok egykristály szilícium ostya, kivágott a tuskó és mechanikus és kémiai polírozás. Szubsztrátok kerülnek a grafit bázis, fűtött nagyfrekvenciás áramok. Megkezdése előtt a lerakódást a szubsztrát maratjuk, gáz közvetlenül a reaktorban hozzáadásával HC1 gőz vivőgáz áramlási. A maratási fordul elő, hogy reverzibilis reakció (2.1) lehetővé teszi, hogy egy tiszta oxidálatlan felületén a félvezető. A növekedési ráta aránya szabályozza gázáramok a reagensek és a hőmérséklet. Optimális körülmények között ez 15-20 nm / s. A gyakorlatban, egy réteg vastagsága 2 és 20 mikron. Dopping rétegek végzik a gőz vegyületeket tartalmazó szennyező elemek (például RSl3, BBr 3, AsH3, stb).
A viszonylag alacsony üzemi hőmérséklet és alacsony kristályosodási sebességet okozhat nagy tisztaságú és strukturális tökéletessége letétbe epitaxiális réteg. Epitaxiális növekedése szerkezetek p -n csomópontok elterjedt az elem izolálására integrált áramkör régió a tértöltés, a hossza, amely növeli alkalmazásakor a fordított előfeszítő hogy a pn átmenetet.
Egyes esetekben, a integrált áramkör gyártási, epitaxiális réteg szilícium lerakódott egykristályos dielektromos hordozót. Amint az anyag ilyen szubsztrátok segítségével a különböző anyagok :. Sapphire (Al2O3), spinell (MgOAl2O3), berillium-oxid (BeO), kvarc (SiO 2), stb Silicon epitaxia dielektromos szubsztrátok megnyitja a lehetőségét integrált áramkörök közel ideális szigeteléssel elemek.
A szilícium felületen. A félvezető felület nem megfelelően védett külső behatások, általában instabil tulajdonságokkal. Adszorpciója különböző szennyeződések a felületen képződése kíséri további energiaszintek A tiltott sávban a félvezető. A újraelosztása töltéshordozók között tömb és felületi állapotok jelentősen befolyásolja a villamos tulajdonságait a felületi régióban (akár a kialakulását a réteg az ellenkező vezetési típusú). A szilícium felületen után minden tisztítás után rövid ideig tartó érintkezést levegő bevonatos-oxid film, melynek vastagsága változik a tartományban 1-5 nm. vékony oxidfilm képződését tovább bonyolítja a képet energiaszintek, mert a felület állam lehet, nem csak a félvezető, hanem az oxid. Sok esetben a felszíni jelenségek vannak a jellemzői a készülékek nagyobb hatással, mint a fizikai tulajdonságait a félvezető hangerőt. Ez teszi a használatát a különböző passzíválásához bevonatok védik a féivezetőfelüiet és kialakítva p -n csomópontokban a környezetet. A szilícium-eszközök, mint a passziváló bevonófilm SiO2, legáltalánosabban alkalmazott. Annak érdekében, hogy megvédje a felületet a félvezető igényel elég vastag oxidrétegekkel gyártott speciális termesztés. Ezzel egyidejűleg, ezek a rétegek szolgálnak elfedő bevonattal gyártásához planáris tranzisztorok és integrált áramkörök által fotolitográfiai technikák és szelektív diffúziót a szennyeződések.
Leggyakrabban oxid film termesztenek a szilícium felületen termikus oxidáció. Az oxidációs eljárást úgy hajtjuk végre hőmérsékleten 1100 - 1300 ° C hőmérsékleten olyan atmoszférában tiszta oxigén vagy vízgőz. A rétegek által termelt termikus oxidáció, azzal jellemezve, hogy üveges állapotból, és tulajdonságai nagyon közel van a olvasztott kvarc. Ezek könnyen vésett vizes hidrogén-fluorid oldatot.
A réteg termikus-oxid képes, hogy megvédje a félvezető diffúzió a külső környezet penetráció számú elektromosan aktív szennyezéseket. A maszkolási tulajdonságai oxid SiO2 használt folyamatok során a helyi diffúziós a szennyeződések előre meghatározott tartományában a egykristály szilícium lemez egy különleges ablak, megnyílt az oxidréteget. Ha a szennyezések diffúz viszonylag szabadon a réteg SiO 2, tekintettel a szennyeződések a szilícium-oxid, hogy lesz egy rossz maszkolási képességét. Az egyszerű elfogadóhelyek csak bór viszonylag alacsony együtthatója diffúzió-oxidot tartalmaz. Ehhez kapcsolódik gyakorlatilag kizárólagos használata bór létrehozni p-típusú régiók szilícium sík eszközök. Gallium diffundál a-oxid körülbelül 400-szor gyorsabb, mint a szilícium. Gyorsabb áthatol a SiO2-alumínium. Egyszerű donorok (foszfor, arzén, antimon) lassan diffundálnak keresztül a SiO 2, és az oxid hatékonyan elfedik a szilikon behatolása a szennyeződések. A legszélesebb körben használt technológia a planáris foszfor. Ez annak a ténynek köszönhető, hogy van egy szilícium diffúziós együttható nagyobb, mint az arzén és antimon, és magasabb, mint az antimon, a határ oldékonyságot.
Még jobb védő és dielektromos tulajdonságok a szilícium-nitrid Si3N4 film. Még nagyon vékony rétegben szilícium-nitrid a sorrendben 0,1 mikrométer vastag, hőmérsékleten 1100-1200 ° C nem áteresztő, a többség a donor és akceptor szennyeződések használt dopping a diffúziós szilícium. Alkalmasak a gyakorlati használatra Si3N4 rétegek gyakran letétbe reakciójával szilán ammóniával a nitridálási hőmérsékleten 700-1100 ° C-on:
A legegyszerűbb módszer, hogy megkapjuk nitrid közvetlen reakcióval nitrogén szilícium, ellentétben a termikus oxidációs, nem talált gyakorlati alkalmazása miatt a nagyon alacsony reakciósebességet a nitridáló és magas üzemeltetési hőmérséklettel.
Való alkalmazásra sík technológia eszközök és az integrált áramkörök kívánatos állagú amorf rétegek, mivel ez csökkenti a mechanikai igénybevétel a határfelületen a szubsztrátummal és csökkenti a valószínűségét olyan hibáktól, mint rések és repedések kialakítva az interfészek a szemcsék között a rétegnek egy kristályos szerkezetű. Kézhezvételét követően nitrid a reakció (2.2) mindig amorf réteg, ha a szilícium hordozó hőmérséklete nem haladja meg 900 ° C-on
Polikristályos szilícium. A gyártás a nagy integrált áramkörök egyre szélesebb körben terjednek alapuló módszer használata polikristályos szilícium. A jellemzője ezt a módszert abban a tényben rejlik, hogy a felület szilícium ostya bevont dielektromos film SiO 2, letétbe egy réteg polikristályos szilícium, amely el tudja végezni a funkciója az ellenállás, összekapcsolási és a kapcsolattartó régiók az emittere és kollektora a tranzisztor. A legtöbb esetben, a lerakódás végzi eljárás a termikus bomlása során szilán SiH4. A szilán a módszer lehetővé teszi, hogy kapjunk egy sűrű réteg finomszemcsés szerkezetű, viszonylag alacsony hőmérsékleten (700-1000 ° C).
Nagy ellenállású polikristályos szilícium kombinálva egy oxidréteg a SiO2 arra használnak, hogy egy megbízható dielektromos szigetelés között elemek integrált áramkörök. Az ábrán látható elrendezésben. 9, különálló régióit monokristályos szilícium beágyazva egy polikristályos szubsztrát és elválasztva egymástól az oxidfilm. Ilyen sík szerkezet alakul ki a monokristályos szubsztrát (ábra. 9a), amelyet ezt követően távolítani csiszolással.
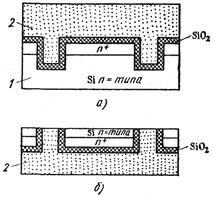
Ábra. 9. izolálása integrált áramköri elemek alkalmazásával polikristályos szilícium 1 - kezdeti egykristály hordozó; 2 - polikristályos réteg
Létrehozásához a vezetőképes film és film ellenállások gumiabroncs használata adalékolt polikristályos szilíciumréteg fajlagos felszíni ellenállása = 20 Rweak ¸ 60 ohm. Dopping rétegek végezzük akár egyidejűleg a lerakódás vagy az ezt követő diffúziós. Ellentétben egykristály szilícium, polikristályos rétegeket normál körülmények között jellemző egy negatív hőmérsékleti együtthatója ellenállás. A gyártás a nagy léptékű, integrált chipek átkötések poliszilícium eljárás számos előnnyel alumínium fémezést felületén. Ezek végrehajtása drámaian növelik a sűrűséget az elemek és a teljesítmény nagyszabású integrált áramkörök.
A szilícium. Szilícium az az alapanyag gyártásához planáris tranzisztorok és integrált áramkörök. A fejlesztés a sík technológia szilícium eszközök lehetővé tette, hogy egy minőségi ugrás a félvezető iparban. Félvezető integrált áramkörök, amelyre jellemző az igen kis méretű és bonyolult konfiguráció aktív területeket talált különösen elterjedt a befogadó és erősítő gépek és számítástechnikai berendezések.
Annak ellenére, hogy a gyors fejlődés integrált mikroelektronika, a teljes kibocsátás a félvezető termékek teszik ki jelentős hányadát szilícium diszkrét eszközök. Made szilícium egyenirányító, pulzáló és mikrohullámú diódák, alacsony frekvenciájú és nagy frekvenciájú, nagy teljesítményű és alacsony fogyasztású bipoláris tranzisztorok, térvezérlésű tranzisztorok és CCD. Működési frekvencia sík tranzisztorok eléri a 10 GHz-es.
Szilícium egyenirányító diódák csomópont képes ellenállni fordított feszültségek akár 1500 V és a folyó áram az előrefelé akár 1500 A, jelentősen meghaladó ezek a paraméterek germánium diódák.
Szilikonból készült zener diódák és tirisztorok leginkább. Zener-dióda, mértékétől függően a adalékolóanyagok rendelkeznek feszültség stabilizálása 3 400 V
A széles körben elterjedt használata a technikát találtak a fényérzékeny szilícium eszközök, különösen a fotodiódák, azzal jellemezve, hogy egy nagy sebességű. Spectrum fényérzékenység szilícium fotodetektorok (0,3-1,1 mikron) jól egyezik emissziós spektruma számos félvezető fényforrások. Silicon napelemek, átalakítására napenergia elektromos árammá nevezzük napelemek. Hozzá vannak szokva a űrhajó áramellátó rendszerek. A hatásfoka a legtöbb esetben 10-12%.
Mint Németország, szilícium gyártásához használt nukleáris sugárzás detektorok, Hall-szenzorok és a terhelés sejtek. A múltban már használt erős függését az ellenállás a mechanikai feszültséget.
Annak a ténynek köszönhetően, hogy a szilícium szélesebb bandgap, mint a germánium, szilícium eszközök is működtethető magasabb hőmérsékleten, mint a germánium. A felső hőmérséklethatár működési szilícium eszközök eléri 180-200 ° C-on